
封裝技術(shù)在半導(dǎo)體行業(yè)中至關(guān)重要,它不僅保護(hù)芯片,還提供電氣連接和散熱路徑。按照不同的封裝形式和應(yīng)用領(lǐng)域進(jìn)行分類,半導(dǎo)體封裝技術(shù)主要包括:
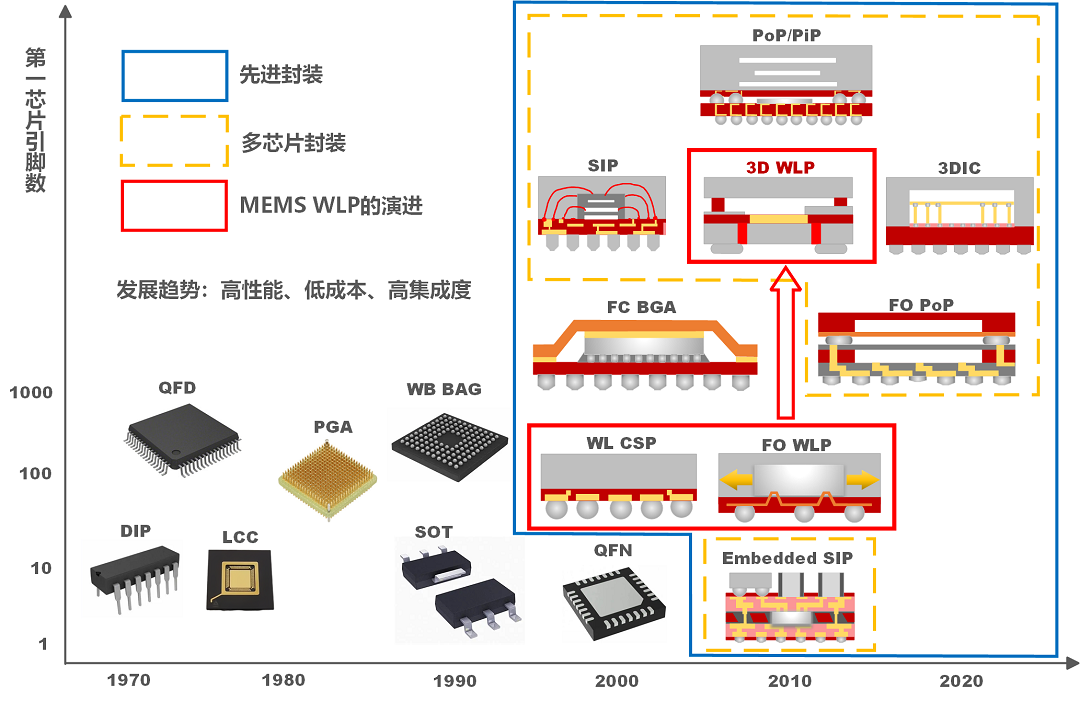
圖1. 封裝工藝演進(jìn)
區(qū)別于傳統(tǒng)的芯片封裝方式,晶圓級封裝(WLP)技術(shù)是在整個(gè)晶圓上進(jìn)行封裝和測試,然后再將封裝好的晶圓切割成單個(gè)芯片。在所有封裝形式中,WLP是唯一一種在晶圓基礎(chǔ)上不額外增加面積的形式。這種方法提高了生產(chǎn)效率,降低了成本,改善了性能。另外,WLP可以把封裝后的濾波器厚度做到0.2-0.3mm之間,遠(yuǎn)遠(yuǎn)低于CSP的厚度。隨著手機(jī)的普遍輕薄化,特別是折疊屏的大面積推廣,射頻器件的厚度降低成為了硬指標(biāo),WLP的重要性越來越明確。
最近30年,隨著各類MEMS產(chǎn)品的不斷問世,先進(jìn)的MEMS封裝技術(shù)層出不窮。MEMS封裝建立在IC封裝的基礎(chǔ)之上,并衍生出各類WLP結(jié)構(gòu)和工藝,WLP有五個(gè)關(guān)鍵技術(shù)點(diǎn),分別是硅通孔(Through Silicon Via, TSV)技術(shù)、再布線(Redistribution Layer, RDL)技術(shù)、凸點(diǎn)制造或凸點(diǎn)工藝(Bumping)、晶圓鍵合(Wafer Bonding)技術(shù)、電鍍(Plating)。
1. 硅通孔(Through Silicon Via, TSV)技術(shù)

通過在硅晶圓中鉆孔并填充導(dǎo)電材料,形成垂直方向的電氣連接通道,從而實(shí)現(xiàn)芯片之間或者芯片內(nèi)部不同層級的直接互連。
2. 再布線(Redistribution Layer, RDL)技術(shù)

通過在芯片或封裝的表面重新分配和布局互連線路,提供更加靈活和高效的電氣連接,支持多種I/O配置和高密度互聯(lián)需求。
3. 凸點(diǎn)制造或凸點(diǎn)工藝(Bumping)
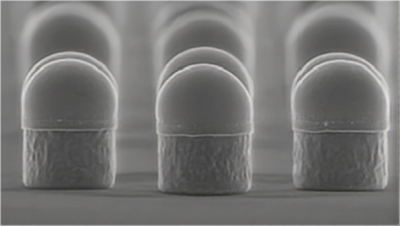
通過在芯片的I/O墊片上形成一個(gè)或多個(gè)微小的金屬凸起結(jié)構(gòu),實(shí)現(xiàn)芯片與封裝基板或其他芯片之間的高效、可靠的電氣互連。
4. 晶圓鍵合(Wafer Bonding)技術(shù)

通過將兩個(gè)或多個(gè)經(jīng)過高度拋光的晶圓緊密連接在一起,形成單一的復(fù)合結(jié)構(gòu)。這種鍵合技術(shù)旨在形成穩(wěn)定、高強(qiáng)度的結(jié)合,適用于那些不需要再次訪問底層晶圓的器件結(jié)構(gòu)。
5. 電鍍(Plating)

利用電解原理在導(dǎo)電物體表面沉積一層金屬或合金涂層。在WLP技術(shù)中,電鍍參與TSV的金屬填充,Bumping形成,RDL制造等。
BAW濾波器是具有三維機(jī)械結(jié)構(gòu)(振動(dòng)的諧振器單元)的射頻MEMS器件,其結(jié)構(gòu)工作時(shí)需要穩(wěn)定的外部環(huán)境。這樣的特征,決定了BAW濾波器的封裝與傳統(tǒng)IC封裝存在諸多不同,且工藝更加復(fù)雜。如果說IC封裝是平面二維的,WLCSP,F(xiàn)O-WLP等晶圓級封裝工藝,是為了集成更多的引腳;BAW濾波器封裝則是立體三維的,引腳之外,更重要的是提供密封的空腔,讓諧振器在穩(wěn)定的環(huán)境中實(shí)現(xiàn)自由的振動(dòng),所以BAW需要“3D WLP“。
目前BAW濾波器成熟的WLP技術(shù)路線包括:
Avago:Shaped Si Cap + Au-Au Bonding (Microcap)
Qorvo:Polymer Cap + Organic Bonding
Skyworks:Copper Filled TSV + Cu-Sn Bonding
Newsonic:Raw Si Cap + Organic Bonding(SiRoof®)
Avago:Shaped Si Cap + Au-Au Bonding
Avago的FBAR在2003年左右就實(shí)現(xiàn)了WLP技術(shù) – Microcap,并且布局了核心技術(shù)專利Microcap,其核心是成型硅蓋Shaped Si Cap和金金鍵合Au-Au Bonding(US8232845B2)。彼時(shí)整個(gè)MEMS的晶圓級封裝技術(shù)還不是很完善,而傳統(tǒng)SAW濾波器也還在使用古老的陶瓷管殼以及打金線的封裝方式。Avago選擇了相對成熟的金屬環(huán)熱壓鍵合(Metal Diffusion路線)封裝,所使用的材料是金。Avago 的Microcap技術(shù)核心包含構(gòu)筑于Cap Wafer上的TSV,形成空腔的硅凸點(diǎn)和凸環(huán),用于鍵合及電連接的Au Gasket (墊圈結(jié)構(gòu))。通過TSV及硅凸點(diǎn)等方案的合理結(jié)合,在保證密封的同時(shí)實(shí)現(xiàn)了有效的電氣互聯(lián)。
圖2. Avago晶圓級封裝專利
Avago獨(dú)特的WLP技術(shù)Microcap對于后續(xù)20年FBAR的大規(guī)模商用功不可沒,這種全硅的方案給后道封裝帶來極大的便利,保證了Avago在模組方案中,能夠進(jìn)行更高密度的集成。一份2019年的調(diào)研報(bào)告(Yole)顯示:Avago在其中高頻發(fā)射模組中(尺寸為7.22×6.23mm,厚0.76mm)集成了19顆FBAR濾波器,單顆濾波器面積僅為1mm2的1/2。
圖3. Avago: Shaped Si Cap + Au-Au Bonding
Qorvo:Polymer Cap + Organic Bonding
Qorvo的Polymer Roof WLP方案比Avago要晚幾年,采用的是雙層干膜封裝:有機(jī)干膜蓋板(Polymer Cap)和干膜-干膜鍵合(Organic Bonding),與傳統(tǒng)懸浮結(jié)構(gòu)不同,SMR的核心振動(dòng)結(jié)構(gòu)并非完全懸浮,而是僅有一面在自由振動(dòng),這種設(shè)計(jì)極大簡化了工藝流程,降低了制造難度,使得諧振器在WLP封裝階段能承受更多的工藝處理步驟,從而提高了成品率和可靠性。
Qorvo在WLP技術(shù)上采取的雙層干膜方案是其一大特色。首層干膜主要負(fù)責(zé)構(gòu)建空腔的側(cè)壁,確保內(nèi)部結(jié)構(gòu)的穩(wěn)定;第二層干膜則如同屋頂,覆蓋于頂部,形成完整的封裝結(jié)構(gòu),為內(nèi)部器件提供保護(hù)。電氣互聯(lián)則采用了先進(jìn)的銅柱技術(shù),通過直接在晶圓上形成垂直互連線,顯著提高了集成度。
值得一提的是,Qorvo WLP技術(shù)中所使用的干膜材料是一種高性能的光敏樹脂,這種材料的成本昂貴,有限的供應(yīng)商也對供應(yīng)鏈提出了挑戰(zhàn)。這種材料的供應(yīng)全部來源于日本廠商。
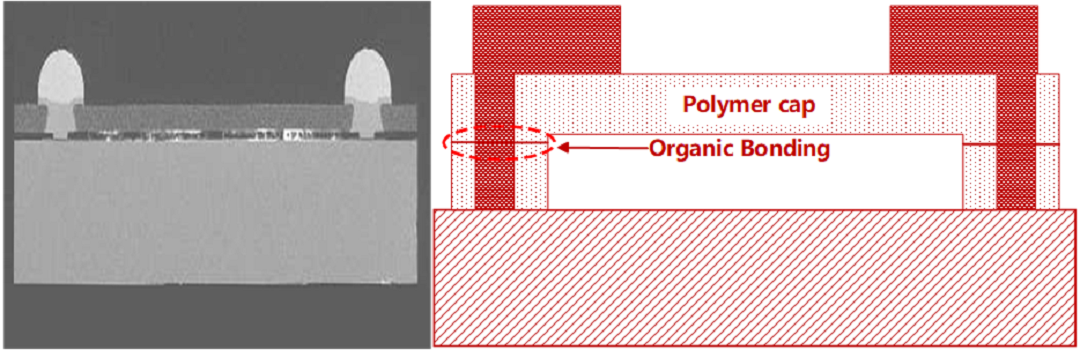
圖4. Qorvo: Polymer Cap + Organic Bonding
Skyworks:Copper Filled TSV + Cu-Sn Bonding
Skyworks于2017年左右推出了FBAR產(chǎn)品系列,其封裝特點(diǎn)為實(shí)心銅柱填充(Copper Filled TSV)+銅錫鍵合 (Cu-Sn Bonding)。不同于傳統(tǒng)金材料鍵合技術(shù),Skyworks開創(chuàng)性地采用了銅錫合金作為鍵合材料,這一選擇不僅優(yōu)化了成本,還提升了鍵合過程的熱穩(wěn)定性與可靠性。
尤為值得一提的是,Skyworks在鍵合環(huán)設(shè)計(jì)上采取了創(chuàng)新策略,選用厚銅材質(zhì)構(gòu)筑了密封鍵合環(huán),這一銅環(huán)不僅厚度顯著,而且同時(shí)充當(dāng)了空腔結(jié)構(gòu)的側(cè)壁,簡化了制造流程。
圖5. Skyworks:Copper Filled TSV + Cu-Sn Bonding
在實(shí)現(xiàn)內(nèi)部互連方面,Skyworks的FBAR產(chǎn)品采用了實(shí)心銅柱作為TSV,這不僅提升了電流承載能力,還顯著改善了熱傳導(dǎo)性能,有利于器件的散熱。同時(shí),用于電氣連接的凸點(diǎn)亦全部采用銅材質(zhì),與TSV形成統(tǒng)一的金屬系統(tǒng)。厚銅材料的廣泛應(yīng)用,大幅度降低了材料成本,為Skyworks的FBAR產(chǎn)品提供了更高的成本效益,使其在競爭激烈的市場中脫穎而出。這一創(chuàng)新鞏固了Skyworks在射頻組件市場的領(lǐng)先地位,為其客戶在5G時(shí)代的產(chǎn)品設(shè)計(jì)提供了更加高效、可靠的解決方案。
Newsonic:Raw Si Cap + Organic Bonding
新聲半導(dǎo)體(Newsonic)于2021年面向市場推出了原創(chuàng)的采用SiRoof封裝方案的D-BAW產(chǎn)品系列。其特點(diǎn)為完整硅帽(Raw Si Cap)+ 干膜有機(jī)鍵合 (Organic Bonding),并且新聲在中美布局了核心技術(shù)專利US20220103147A1和CN113556098B。SiRoof設(shè)計(jì)中對TSV的布局不同于常規(guī)WLP做法,將電氣互聯(lián)的TSV設(shè)置在器件的一側(cè),而非Cap(硅帽)一側(cè),這樣的設(shè)計(jì)意味著電流路徑無需穿越鍵合界面,從而有效避免了因鍵合界面殘余應(yīng)力引起的潛在可靠性問題,可靠性等級與Avago一致,大幅增強(qiáng)了產(chǎn)品的穩(wěn)定性和耐用性。相比于經(jīng)多層光罩,多道工藝復(fù)雜加工的Microcap,新聲SiRoof晶圓只需一道光罩,像屋頂(Roof)一樣蓋在了有機(jī)鍵合層形成的墻上,整體縮短了制造周期,降低成本。
圖6. Newsonic雙面鍵合技術(shù):Raw Si Cap + Organic Bonding
BAW WLP的跨行業(yè)嫁接開花結(jié)果
SiRoof是如何誕生的呢?
眾所周知,影像是全人類的旺盛需求,人們的生活被手機(jī)攝像頭徹底的改變了。1990年代,手機(jī)拍照技術(shù)開始逐漸發(fā)展并迅速普及,隨后智能手機(jī)攝像頭顆數(shù)和性能需求急劇攀升。

圖7. 網(wǎng)友調(diào)侃現(xiàn)代攝像頭是麻將牌
同樣于1990年代,得益于CMOS技術(shù)的低功耗、高集成度和低成本優(yōu)勢,CMOS圖像傳感器開始逐漸取代電荷耦合器件(CCD)成為手機(jī)攝像頭成像技術(shù)的核心。現(xiàn)今全球每年約生產(chǎn)70億顆CIS,七成用于手機(jī)。2000年前后,CIS對更高分辨率、更低功耗和更小尺寸的需求催生了CIS WLP技術(shù)的飛速演進(jìn)。
2010年代初期,以色列Shellcase公司開發(fā)了CIS傳感器使用的晶圓級硅通孔封裝技術(shù)(TSV)。實(shí)現(xiàn)了芯片間的高效垂直互聯(lián),大幅提高了數(shù)據(jù)傳輸速度和功耗效率。這種技術(shù)在三維堆疊(3D Stacking)封裝結(jié)構(gòu)中得到了廣泛應(yīng)用,多層電路和器件可以堆疊在一起,顯著提升了功能集成度和性能,同時(shí)減少了封裝體積。
圖8. CIS WLP的現(xiàn)代以TSV為基礎(chǔ)的封裝形式[6]
在中國半導(dǎo)體產(chǎn)業(yè)2010年代初快速發(fā)展的大背景下,CIS WLP封裝技術(shù)在國內(nèi)逐漸實(shí)現(xiàn)國產(chǎn)化,并且擁有了成熟的生產(chǎn)線。至今,核心工藝TSV已非常先進(jìn)成熟。
巧合的是,BAW的WLP也有此類減小電氣互聯(lián)寄生、保障可靠性及密封性、和縮小尺寸的需求,新聲尋求到CIS WLP大規(guī)模制造龍頭合作方共同開發(fā)嘗試將CIS WLP直接嫁接到DBAW晶圓,沒想到完全兼容迅速成功,即SiRoof(Raw Si Cap + Organic Bonding)。隨后,雙方又合作攻克了窄邊框晶圓鍵合,復(fù)雜介質(zhì)的刻蝕等工藝難點(diǎn),在大批量生產(chǎn)中進(jìn)一步提升了可靠性余量。
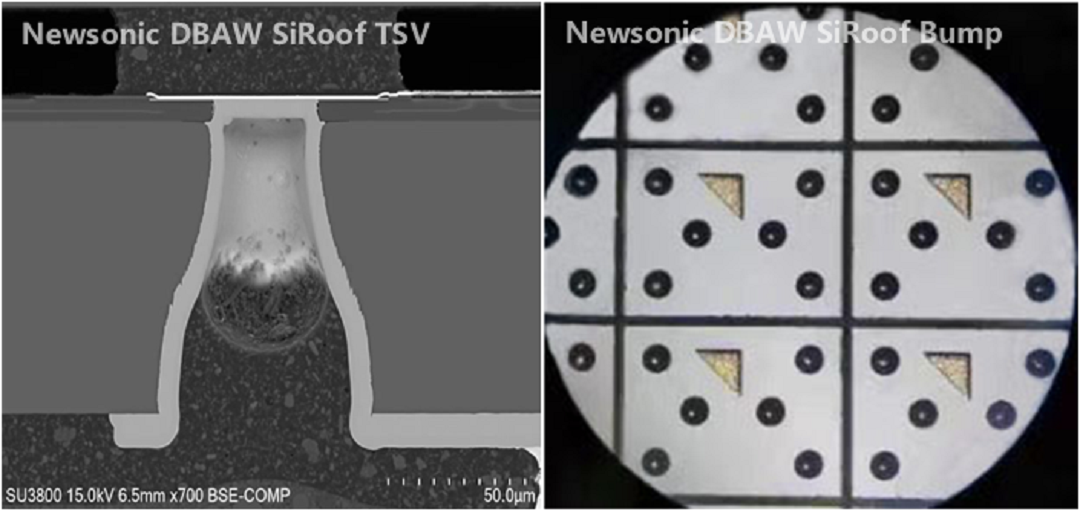
圖9. Newsonic改進(jìn)后的DBAW SiRoof的TSV和整齊排列Bump實(shí)拍照
BAW WLP 技術(shù)及IP的橫向發(fā)展
起于CIS行業(yè)WLP技術(shù)的靈感激發(fā),后續(xù)又融合了SiP等先進(jìn)封裝技術(shù)點(diǎn)。新聲半導(dǎo)體(Newsonic)橫向延展出BAW WLP的技術(shù)及IP家族,包括封裝結(jié)構(gòu),工藝方法等八大類別的專利布局,如圖10。
圖10. 新聲(Newsonic)核心關(guān)鍵技術(shù)WLP的專利布局
新聲下一代Glass-Cap
BAW濾波器的晶圓級封裝技術(shù)(WLP)依舊不斷迭代擁有無限可能,朝著進(jìn)一步提高生產(chǎn)效率、降低成本且不損失性能的方向,新聲半導(dǎo)體同步在開發(fā)基于更便宜材料和制造的玻璃晶圓蓋帽WLP(如圖11)的新型封裝技術(shù)。
圖11. 新聲下一代Glass-cap玻璃蓋帽產(chǎn)品
寫在最后
Avago、Skyworks、Qorvo等公司自由創(chuàng)新發(fā)展各自的BAW WLP技術(shù),其中Avago和Sky主要基于“金屬鍵合”、Qorvo基于“雙層干膜”。Newsonic則站在CIS巨人肩膀上發(fā)展出先進(jìn)穩(wěn)定的SiRoof技術(shù),充分糅合了CIS行業(yè)TSV的先進(jìn)性、巨大產(chǎn)能的低成本,配合新開發(fā)的窄邊框有機(jī)鍵和技術(shù)、平坦未處理SiRoof材料,實(shí)現(xiàn)了自己的BAW WLP。
《三體》中關(guān)于技術(shù)爆炸理論有一段經(jīng)典的描述:“……地球生命史長達(dá)十幾億年,而現(xiàn)代技術(shù)是在三百年時(shí)間內(nèi)發(fā)展起來的,從宇宙的時(shí)間尺度上看,這根本不是什么發(fā)展,是爆炸!技術(shù)飛躍的可能性是埋藏在每個(gè)文明內(nèi)部的炸藥,如果有內(nèi)部或外部因素點(diǎn)燃了它,轟一下就炸開了……”。近二十年全球智能手機(jī)的發(fā)展不僅改變了人們的生活,也催生了“環(huán)智能手機(jī)”產(chǎn)業(yè)鏈的文藝復(fù)興式技術(shù)爆炸,射頻通訊行業(yè)和CIS行業(yè)都是其中一員。在這個(gè)璀璨的時(shí)代,我們都不光自己在發(fā)光,也能借到別人的光。
參考文獻(xiàn)
[1] United States Patent US9219464 - Bulk Acoustic Wave (BAW) Resonator Structure Having an Electrode with a Cantilevered Portion and a Piezoelectric Layer with Multiple Dopants: https://patentimages.storage.googleapis.com/a4/25/02/1e0ba32593084f/US9219464.pdf
[2] United States Patent US8232845B2 - Packaged Device with Acoustic Resonator and Electronic Circuitry and Method of Making the Same: https://patentimages.storage.googleapis.com/8f/92/b0/ed6ee6c47a65d3/US8232845.pdf
[3] United States Patent US8143082B2 - Wafer Bonding of Micro-electro Mechanical Systems to Active Circuitry: https://patentimages.storage.googleapis.com/9d/59/fa/6486ad02d1a6c3/US8143082.pdf
[4] United States Patent US20220103147A1 - Lithium Niobate or Lithium Tantalate FBAR Structure and Fabricating Method Thereof
[5] 中華人民共和國國家知識產(chǎn)權(quán)局發(fā)明專利CN113556098B - 體聲波諧振器封裝結(jié)構(gòu)
[6] 馬書英,王姣,劉軼,等. 淺析CMOS圖像傳感器晶圓級封裝技術(shù)[J]. 電子與封裝, 2021, 21(10): 100108
 Search
Search